Review: Novel Assemble Approaches for 3D Devices Stacks

1. 題目與摘要
Title: Novel Assembly Approaches For 3D Device Stacks
Author: Laura Peters, Semiconductor Engineering (2025-06-30)
Executive Summary:
這篇文章聚焦於最新在 ECTC 2025 大會中展示的 3D 晶片封裝創新技術,強調隨著 AI 訓練與推理需求大幅攀升,3D 封裝成為解決熱管理與頻寬瓶頸的關鍵。文中介紹了多家領先企業如 Intel、TSMC、Georgia Tech 等的技術突破,包括 1µm hybrid bonding、晶片內冷卻、光電共封裝(CPO)等。整體趨勢顯示,3D 堆疊正從概念驗證進入實質量產準備階段,並將重新定義 HPC 與 AI 系統的散熱與訊號架構。
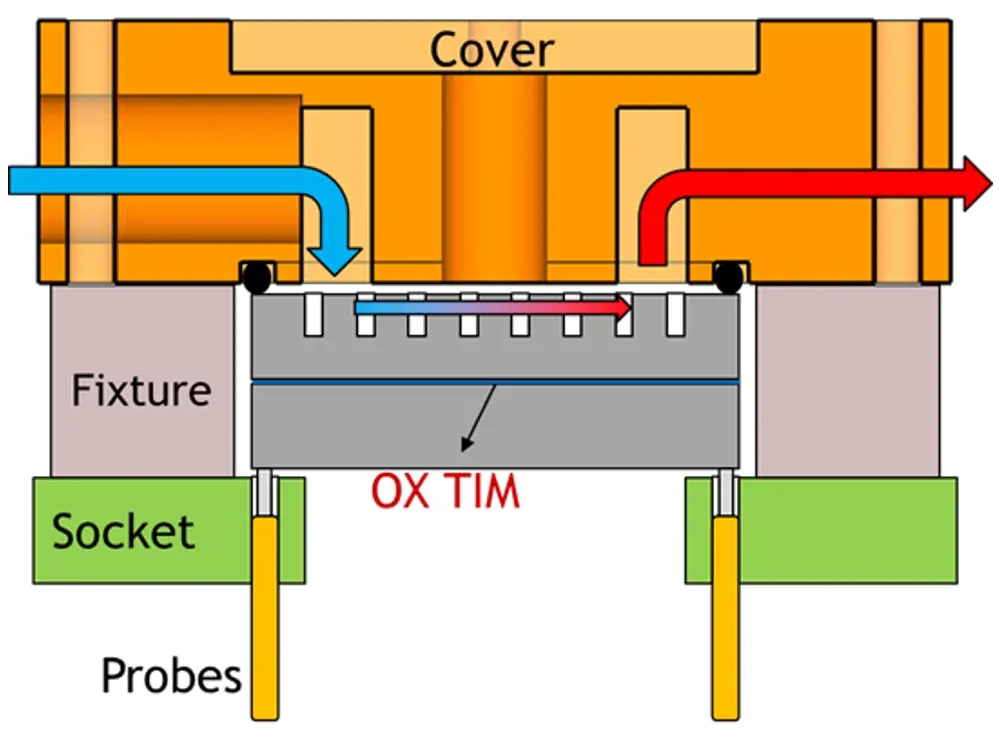
[[ Fig 1: TSMC CoWoS 液冷封裝模組原型圖,展示導入晶片底部冷卻液通道結構 ,TSMC 液冷封裝橫截面圖示,顯示冷卻液由蓋板進入後直接通過晶片底面區域進行散熱,並透過 OX TIM 加強熱導效率(圖片來源:TSMC Interconnect Research) ]]
🔍 圖片說明:
這是一個 液冷散熱封裝模組的橫截面示意圖,圖中要素包括:
元件 | 說明 |
|---|---|
Cover | 液冷蓋板,內含冷卻液流道 |
藍色箭頭 | 冷卻液進入路徑(冷流) |
紅色箭頭 | 冷卻液排出路徑(熱流) |
中間白色結構 | 晶片堆疊區域,可能含有 SoC / HBM |
OX TIM | 氧化物熱介面材料(thermal interface material),幫助導熱 |
Fixture / Socket / Probes | 封裝與測試用夾具與連接器 |
2. 背景與重要性說明
- AI、HPC(高效能運算)正快速推升晶片堆疊密度與功率密度。
- 2D 封裝與傳統空冷無法滿足高熱流密度晶片的散熱需求。
- 晶片堆疊與 chiplet 架構崛起,使熱、頻寬、訊號延遲成為核心瓶頸。
- 因此,需要創新封裝與散熱設計,從材料、結構、冷卻方式全面革新。
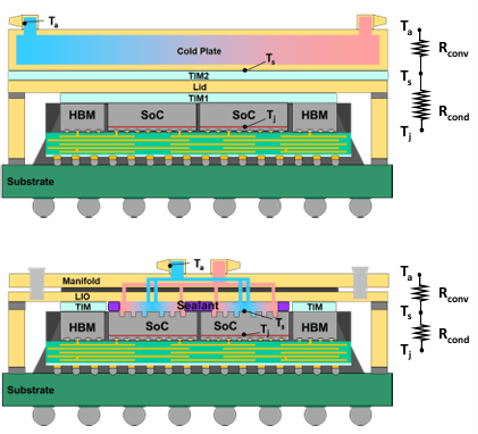
[[ Fig 2: Imec 與 TSMC 於 ECTC 2025 比較傳統 CoWoS 封裝(上)與直接液冷設計(下)之熱流與冷卻架構,指出後者可顯著提升散熱效率(出自 IEEE ECTC 2025, 引用自 Semiconductor Engineering) ]] (CoWoS with direct liquid cooling using 10 L/min water (below) dissipates more heat than CoWoS with TIMs, lid, and cold plate configuration. Source: IEEE ECTC [1])
這張圖展示的是 兩種不同的晶片散熱架構設計比較,常見於高效能 3D IC(如 SoC + HBM 組合)封裝中。圖中搭配了熱阻模型(thermal resistance network)來解釋熱流通路。
🧊 上圖:傳統冷卻方式(Cold Plate + Lid)
結構說明:
- Cold Plate:傳統水冷散熱片,與外部冷卻系統連接
- Lid(蓋板):金屬蓋,中間靠 TIM(熱介面材料)與晶片傳熱
- TIM1 / TIM2:熱介面材料,分別填補 SoC–Lid 與 Lid–Cold Plate 間隙
- SoC / HBM:處理器與高頻寬記憶體模組
- Substrate:基板
熱路模型:
- 熱從 Tj(junction)→ Ts(表面)→ Ta(冷卻液) 傳遞
- 所經熱阻:R_cond(導熱)+ R_conv(對流)
- 中間經過多層介質(晶片→TIM1→Lid→TIM2→Cold Plate)
💧 下圖:嵌入式液冷(Integrated Liquid Cooling)
結構說明:
- Manifold + Sealant:直接在 SoC 上方整合冷卻液流道,靠封裝密封劑隔絕
- 冷卻液流入/流出管道:直接與 SoC 表面接觸進行冷卻
- TIM 較少或無需蓋板:降低熱阻層數
- 熱從晶片內部更快散出
熱路模型:
- 熱從 Tj → Ts → Ta 傳遞,但此設計中 Ts 幾乎 = Tj
- 對流熱阻 R_conv 更貼近熱源,導熱路徑更短、更快
🔍 重點比較:
項目 | 傳統冷卻架構 | 嵌入式液冷架構 |
|---|---|---|
散熱距離 | 長,多層材料 | 短,直接與 SoC 表面接觸 |
熱阻 | 高(TIM1+Lid+TIM2) | 低(直接對流) |
液冷導入難度 | 外部冷卻模組即可 | 封裝需支援冷卻通道與密封結構 |
適用於 | 中低功耗封裝 | 高功率密度 3D 堆疊晶片 |
技術挑戰 | 成熟,但熱阻仍偏高 | 精密封裝整合與材料可靠性要求高 |
📌 這張圖的核心目的:
說明隨著 SoC + HBM 3D 堆疊功率密度提升,傳統冷卻方式已逐漸無法滿足熱通量需求,嵌入式液冷成為下一代趨勢。
3. 主要創新與技術亮點
公司/機構 | 技術亮點 | 重點內容 |
|---|---|---|
Intel | 1µm hybrid bonding | 低 pitch Cu-Cu bonding,提升訊號密度與熱傳導 |
TSMC | CoWoS with direct liquid cooling | 晶片底部導入液冷通道,可支援 4 SoC + 6 HBM 堆疊結構 |
Georgia Tech | chiplet-as-coolant | 將晶片視為冷卻通道本體,透過 TSV/矽中微通道實現液冷 |
Brewer Science / ITRI | 多層聚合物 RDL with hybrid bonding | 展示 10 層結構,整合銅與聚合物導體,實現超密度重分佈層(RDL) |
Corning / Fraunhofer | 光波導玻璃基板 | 作為 CPO 基板,兼容光電整合並維持熱穩定性 |
Samsung | 散熱強化封裝 | 導入高熱導銅底板技術,應用於 DRAM 與行動處理器 |
Imec | 熱模擬與功率分佈分析 | 進行多晶粒封裝熱管理建模與實驗,以評估高熱密度區域與冷卻效益 |
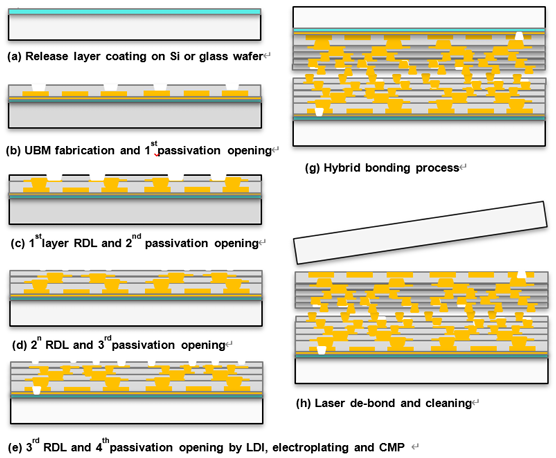
[[ Fig 3: Intel hybrid bonding 橫截面圖示,呈現 1μm Cu-Cu 鍍層與對位結構 , Intel hybrid bonding 封裝製程流程圖,展示多層 RDL 製作後,進行 Cu-Cu 混合鍵結並對位整合(圖片來源:Intel 於 IEEE ECTC 發表之封裝技術論文)
📌 圖片說明與流程:
這是 Intel 在其先進封裝流程中所採用的 Hybrid Bonding 製程的流程橫截面圖解,具體說明如下:
圖塊步驟 | 說明 |
|---|---|
(a) | 在玻璃或矽晶圓上塗佈釋放層(release layer) |
(b) | 製作 UBM(Under Bump Metallization)與第一次 passivation 開口 |
(c)-(e) | 進行多層 RDL(Redistribution Layer)與 passivation 開口,通常至第 3 或第 4 層 |
(f) | 鍍銅與平坦化處理(電鍍 + CMP) |
(g) | 關鍵步驟:Hybrid bonding(包含 Cu-to-Cu bonding + Oxide bonding)→ 圖中灰白/黃色分層顯示對位與導通結構 |
(h) | 最後使用雷射除膠與晶圓分離(Laser de-bond and cleaning) |
🔍 重點資訊:
- 黃色區域:銅層(Cu)
- 灰白結構:矽層與氧化層
- 結構密度高、pitch 極小,約為 1μm 級 Cu-Cu bonding
- 實現「面對面直接堆疊(face-to-face)」的 3D IC 封裝架構
4. 技術可行性與限制分析
- 1µm hybrid bonding:目前已達實驗片水平,但大規模商用尚受限於對位誤差與界面氣泡控制。
- 液冷封裝:需解決微通道可靠性、灌注與封膠技術、長期穩定性問題。
- chiplet-as-coolant:概念具突破性,但在製程整合與熱脹冷縮管理上難度高。
- CPO 光電共封裝:現已進入原型製作,光學對準、封裝光損與熱穩定性為關鍵挑戰。
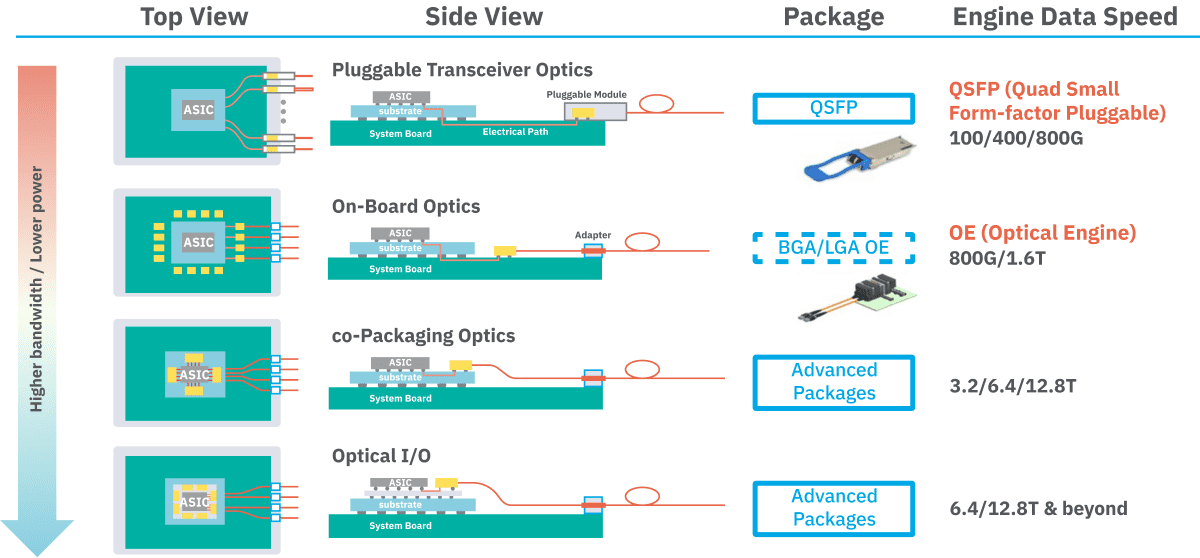
[[ Fig 4: Co-Packaged Optics 架構演進示意圖,展示從 Pluggable、On-Board 至 CPO 與 Optical I/O 各階段整合模式,並對應資料速率與封裝技術需求(出自 ASE Silicon Photonics 技術簡報) ]]
📌 圖片說明解析
這張圖來自 ASE 的官方簡報,對比了四種光模組整合架構的演進,從傳統到先進
架構 | 上視圖與側剖圖 | 封裝型式 | 資料速率 |
|---|---|---|---|
Pluggable Optics | 光模組插拔於主機板上,ASIC 與光模組相隔較遠 | QSFP | 100/400/800G |
On-Board Optics | 光引擎接近 ASIC,但仍獨立封裝 | BGA/LGA OE | 800G / 1.6T |
Co-Packaged Optics (CPO) | 光引擎直接與 ASIC 共封裝(圖中第三項) | Advanced Packages | 3.2 / 6.4 / 12.8T |
Optical I/O | 光模組進一步整合至晶片級別(具未來性) | Advanced Packages | 6.4 / 12.8T & beyond |
- 左側箭頭說明清楚傳輸趨勢: 更高頻寬、更低功耗往下演進
- 第三排正是 CPO 架構核心,與主題完全契合
5. 市場與產業影響
- 資料中心/AI 加速器市場:將是最早導入此類高密度、高散熱封裝技術的應用場域。
- 晶圓代工/封裝業者(TSMC、Intel、ASE 等):需要投入高額資本升級先進封裝產線。
材料供應商(如 Tosoh、Brewer、Shin-Etsu):須提供新一代封裝膠、熱界面材料、導熱聚合物等新材料。

[[ Fig 5: 3D 封裝材料供應鏈圖譜,顯示材料技術、設備與製程供應商在高密度封裝產業中的角色(出自 Yole Development) ]]
6. 觀點與建議
- 本文雖屬技術新聞性質,但引用大量 ECTC 大會報告,具備極高趨勢參考價值。
- 從商業角度,液冷與 chiplet 級散熱將帶動晶圓封裝材料與系統整合解決方案的升級機會。
- 台灣廠商若要參與,建議關注如下三類技術鏈結:
- 無氟冷卻液與密封封裝材料(取代 3M Novec)
- 微通道結構用高精度雷射加工/微蝕刻技術
- 光電/熱共封裝模組整合(特別是 Co-Packaged Optics 模組)
- 機會
(1) 無氟冷卻液材料
TSMC、Imec 等先進封裝大廠已開始導入晶片內建微通道液冷結構,以因應 AI 晶片的極高功率密度需求。由於 3M 已退出 Novec 冷卻液市場,產業對無氟、絕緣型液體材料的替代方案有強烈需求,為 UNK 的熱管理材料產品帶來潛在機會。
(2)導電聚合物用於 CPO(Co-Packaged Optics)製程
ASE、Intel 等正在推動 CPO 封裝架構,將光模組與邏輯晶片共封裝以提升高速低功耗傳輸能力。製程中需導入具備高導電性、光穩定性及製程相容性的特殊導電聚合物。可思考作進一步切入光電封裝供應鏈。
Appendix
原文出處
ECTC 2025“ECTC 2025(第 75 屆 IEEE Electronic Components and Technology Conference)將於 2025年5月27日至30日在美國德州 Grapevine 的 Gaylord Texan Resort & Convention Center 舉行,由 IEEE Electronics Packaging Society 主辦。
