The Industry Role of Backend Packaging Process

後段封裝製程的產業角色
C.Y. LU|2025-07-10
1. 前言
在半導體產業中,後段封裝製程已從過去被視為被動的後製工序,逐步轉型為驅動系統性能、微縮化與異質整合的策略關鍵。隨著摩爾定律的效應逐漸趨緩,異質整合技術迅速興起,後段封裝在實現系統創新中的角色顯得比以往任何時候都更為重要。
本文將探討封裝製程於半導體價值鏈中的轉變地位,並剖析其對技術發展、製造體系與商業模式生態的戰略意涵。

2. 問題陳述
傳統封裝流程如晶圓凸塊、切割、貼合、打線與塑封等,長期以來被視為勞力密集、附加價值有限的標準流程。然而,隨著先進運算(AI、HPC)、邊緣裝置與多晶粒架構(如 2.5D/3D IC、Chiplet)普及,封裝需滿足更高的 I/O 密度、更佳的散熱效能與更短的訊號路徑,同時支援異質整合。
主要挑戰包括:
- 整合來自不同節點與晶圓廠的晶粒
- 微細互連與極薄晶片造成的良率損失
- 高階封裝設備資本密集、投資門檻高
- 傳統 OSAT 設計支援與模擬能力不足
這些缺口使得傳統封裝代工(OSAT)面臨被晶圓代工或系統廠自建先進封裝產線所取代的風險。
3. 現況評估
領先的封裝廠商(如 ASE、Amkor、JCET)正積極轉型,發展具附加價值的封裝解決方案,包括:
- 晶圓級扇出封裝(FOWLP)
- 使用 TSV 進行 2.5D/3D 整合
- 系統級封裝模組(SiP)
- 整合熱管理與 EMI 抑制方案
同時,晶圓代工大廠(如 TSMC 的 CoWoS、InFO)與 IDM(如 Intel 的 Foveros)也正將先進封裝納入其產品與服務鏈,形成明顯分化趨勢:
- 高性能、高毛利封裝 → 被晶圓廠與 IDM 吸收
- 高產能、中階封裝業務 → 留在 OSAT 領域
而車用電子、AR/VR、醫療 AIoT 等新興應用雖具潛力,但也要求封裝廠商進一步提升設計整合、基板創新與熱可靠性。
4. 解決方案建議
為避免被邊緣化並掌握下一代系統整合的價值,後段封裝廠應積極推動以下策略:
- 建構異質整合平台:投資 FOCoS、Chiplet 整合與 Hybrid Bonding 等能力
- 強化設計與模擬服務:建立協同設計平台,支援系統設計者與晶圓廠需求
- 攜手材料與基板創新者:突破高密度 RDL、玻璃基板與熱介面材料的瓶頸
- 與生態系緊密連結:在新竹、矽谷等 Fabless 聚落設立封裝設計據點,強化回應速度與設計互動
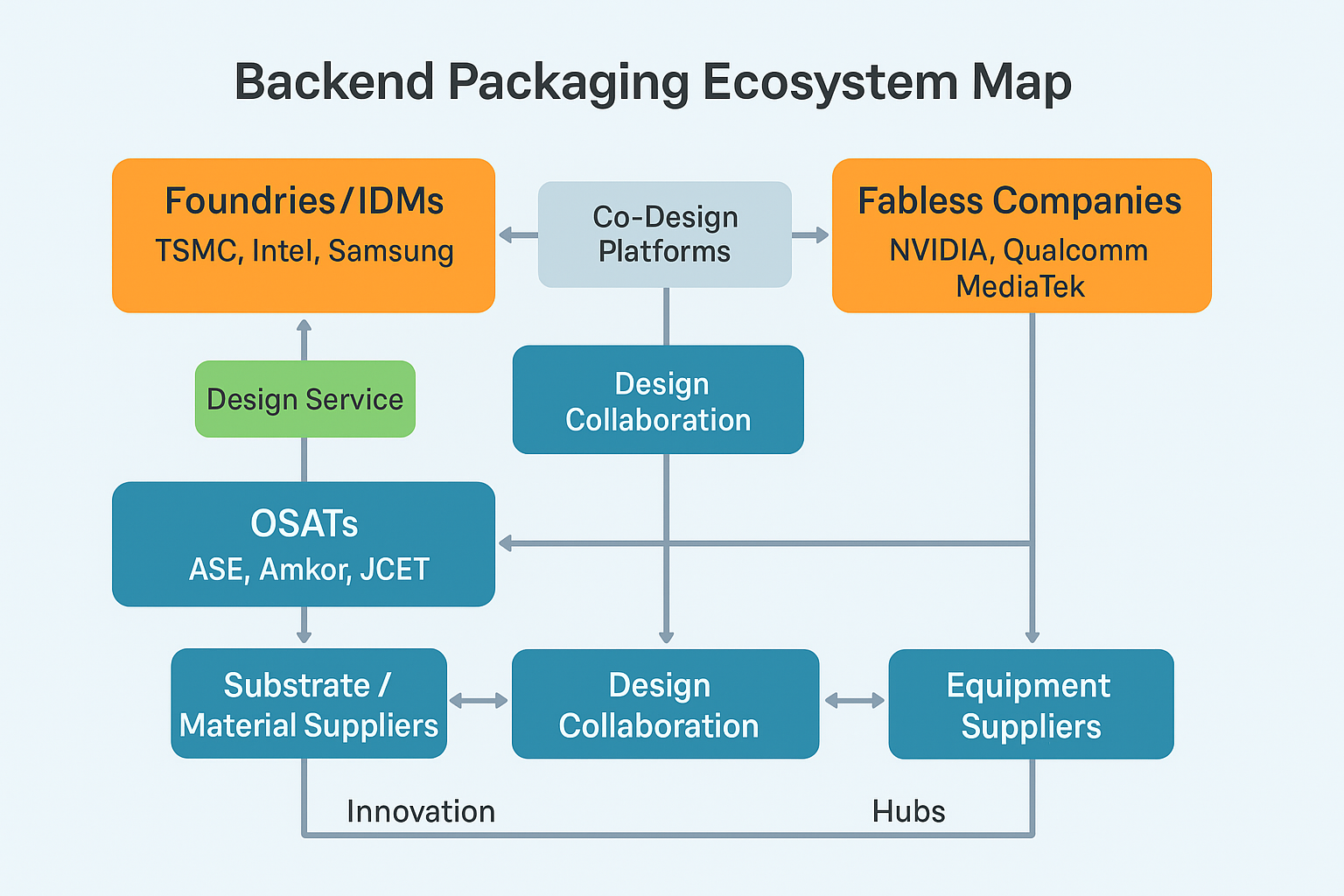
這張圖 [[Figure 3: Backend Packaging Ecosystem Map]] 描繪了後段封裝產業的生態系統關係圖,透過不同角色之間的互動與設計合作流程,說明了誰參與封裝設計、誰推動創新、誰提供材料與設備:
🔷 圖中主要角色與功能說明:
區塊 | 代表單位 | 功能與說明 |
|---|---|---|
Foundries/IDMs(晶圓代工與整合廠) | TSMC, Intel, Samsung | 提供晶圓製造與先進封裝整合服務,可參與設計共構與平台主導。 |
Fabless Companies(無晶圓設計公司) | NVIDIA, Qualcomm, MediaTek | 系統架構與晶片設計者,通常將封裝設計外包,需與代工與封裝廠密切合作。 |
OSATs(封裝與測試代工) | ASE, Amkor, JCET | 提供量產與中高階封裝服務,逐步轉型提供設計協同與系統整合。 |
Substrate / Material Suppliers(基板/材料商) | 各種先進材料與封裝載板供應商 | 提供 RDL、glass core、封裝用導熱介面等材料,參與創新合作。 |
Equipment Suppliers(設備供應商) | 封裝用曝光機、Hybrid Bonder、雷射鑽孔等設備製造商 | 支援高密度封裝需求,與封裝廠共同開發新製程設備。 |
Co-Design Platforms / Design Service | 系統設計平台與服務提供者 | 提供跨晶粒、跨封裝架構的模擬、驗證、設計共構平台。 |
🔁 各角色之間的互動關係:
- Fabless ↔ Co-Design Platforms ↔ Foundries/IDMs
→ 跨平台協同設計晶片與封裝架構 - Fabless ↔ OSATs
→ 指定封裝需求、製造轉交與設計整合(如 SoC + SiP) - OSATs ↔ 材料 / 設備供應商
→ 合作開發先進封裝製程、材料與設備創新(如 glass interposer, hybrid bonding) - Design Service 往上連接至 Foundry/IDM
→ 表示 OSAT 的升級策略之一:由被動代工者轉為設計服務提供者
📌 生態結構重點觀察:
- 設計協同為核心競爭力:誰能提供完整封裝設計支援,誰就更容易掌握價值主導權。
- 創新來源分散:材料與設備供應商角色日益重要,成為 OSAT 的技術升級動力。
- 封裝廠角色轉型中:從單純封裝供應商走向「系統整合」、「設計服務」與「協同開發者」。
5. 關鍵效益
效益類別 | 說明 |
|---|---|
系統性能提升 | 透過短互連達成更佳訊號完整性、更高頻寬與更低功耗 |
商業模式轉型 | 從勞力密集轉向設計與模擬驅動的價值鏈 |
ESG 永續合規 | 先進封裝有助於熱控優化與降低碳足跡 |
地區供應韌性 | 靠近客戶以提升設計協同並降低供應鏈風險 |
6. 結論
後段封裝已不再是「製程的最後一站」,而是系統創新的第一哩路。隨著技術與商業模式的加速融合,封裝單位若能順勢升級、主動參與設計與整合,未來將不只是「供應商」,更是半導體產業的創新驅動者與價值共創者。

這 [[Figure 4: Backend as Innovation Enabler Diagram]] 描繪了封裝代工業者(OSAT)從傳統角色進化為創新推動者(Innovation Enabler) 的四階段轉型路徑,是理解後段封裝策略升級的關鍵概念圖。
🔁 圖中四個階段說明:
階段 | 名稱 | 說明 |
|---|---|---|
1️⃣ | Traditional OSAT(傳統封裝廠) | 僅提供標準化的封裝與測試服務,強調低成本、大量生產。 |
2️⃣ | High-Value Packaging Services(高附加價值封裝) | 提供 FOWLP、SiP、2.5D/3D 等先進封裝技術,開始參與部分產品設計協作。 |
3️⃣ | Design & Simulation Support(設計與模擬支援) | 建立封裝設計平台、模擬工具與與 IC 設計端的協同流程,成為設計夥伴。 |
4️⃣ | Innovation Enabler(創新推動者) | 成為異質整合的系統架構共同設計者,與晶圓廠、IDM、Fabless 並肩開發新一代封裝架構與系統模組。 |
圖示意涵:
- 每個階段的右向箭頭代表「能力升級與價值鏈上移」。
- 最終目標是讓封裝廠成為 不僅是生產者,而是系統創新的共同設計者。
- 這條路徑也暗示了封裝廠在與晶圓代工(Foundry)、IDM 與 Fabless 競爭中的生存與轉型策略。
實際應用示例:
- ASE 由傳統封測廠轉向發展 FOCoS 技術、與系統廠協同設計晶片模組
- Amkor 與車用客戶合作開發耐高溫高可靠封裝設計
- JCET 強化 SiP 設計中心,向 Fabless 提供整合設計模擬服務
Appendix: Key Terminology
| 簡寫 | 英文全名 | 中文說明 |
| OSAT | Outsourced Semiconductor Assembly and Test | 封裝測試代工廠商 |
| FOWLP | Fan-Out Wafer-Level Packaging | 晶圓級扇出封裝 |
| TSV | Through-Silicon Via | 穿矽通孔,用於 3D 封裝中的垂直互連 |
| RDL | Redistribution Layer | 重分佈層,用於重繪 I/O 線路 |
| CoWoS | Chip-on-Wafer-on-Substrate | 台積電的 2.5D 封裝解決方案 |
| SiP | System-in-Package | 系統級封裝,將多顆晶片整合為一模組 |
| FOCoS | Fan-Out Chip-on-Substrate | ASE 發展的先進扇出型封裝技術 |
